为现代光子制造提供最精确的灵活量产芯片贴片解决方案
引言
未来5年,全球5G部署和数据中心应用有望呈指数级增长【1】。这推动了高性能光通信器件的需求,使其成为最重要的基础之一。具体来说,这些关键组件支持5G无线前传和下一代以太网模块的出货,包括2x200GbE、4x100GbE和400GbE,以及CWDM/DWDM收发器【2】。这类新型高性能光学器件的主要市场增长引发了新的贴片需求,包括更小的封装外壳,更高的封装密度,更小的芯片尺寸,更快的技术创新和产品迭代,以及更大的产量需求和更经济的价格。在激光雷达、AR/VR、先进光子传感器、MEMS,甚至高度集成的硅光子器件方面也有同样的需求。
在这些器件的制造过程中,最大的挑战之一是如何成功地部署灵活的芯片贴片解决方案,以满足大批量柔性生产的需求,并能保持较高的贴片后的精度和机器能有良好的长期稳定性【3】。从历史上看,每一代光子器件都有贴片后的精度要求,从15-20微米发展到7-10微米,再到5-7微米。最新一代的高性能光子器件需要小于3微米的贴片后的精度,而且不能牺牲高产出或高灵活性,以实现大批量生产中产品类型的高混合。传统的高产出半导体设备可能具有高精度和高速度,但不具备光子器件所需要的灵活性。也有一些贴片机专门为光子制造设计的,具备准确性,灵活性或者速度,但不能同时满足所有这些要求。在这里,我们介绍的是业界首次在量产环境下验证的,同时具备高速度和高度灵性的贴片机平台MRSI-HVM上实现3微米或更好的贴片后的精度,可用于大批量高混合的光子制造。
大批量高混合光子制造的挑战
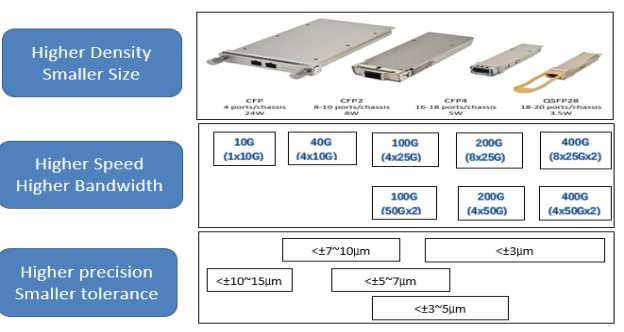
图1 光学器件发展趋势及装配公差
图1说明了光器件的发展趋势,以及伴随的器件装配公差。新一代光器件要求更小的装配公差和更高的贴片后的精度,因而需要更高精度的贴片机。贴片后的精度不仅取决于机器的精度,还取决于芯片和基板的公差,以及工艺的稳定性。总装配公差限度是非常有限的,机器精度和工艺稳定性越高,可以留出更多容差给材料,而且封装工艺成品率也会越高。要想达到<±3微米的贴片后的精度,芯片贴片机需要有稳定的<±1.5微米的机器精度。这种<±1.5微米@3σ的机器精度,加上高速度和高灵活性,对芯片贴片机供应商来说是一个巨大的挑战。
附加的另一个挑战是对更小和更高密度的组件的需求,这些组件可以降低光器件的功耗。对于要求共晶工艺的高密度的器件,需要提供特殊的高精度顶部加热工具,以防止相邻芯片在共晶过程中的二次回流。这种高精度脉冲加热技术在高密度光学器件中是非常有用,但又给芯片贴片机带来了更多的挑战。另外,与硅基的电芯片不同,光子芯片通常非常脆弱,对贴片焊头的结合力需要精准控制,这个也是非常关键的。【3】
图2比较了颠覆性的基于云的新数据中心的业务模型与传统的以电信为中心的业务模型。【4】 在这个比较中,新的基于云的数据中心模型要求包括一个满足订单规模的大型制造基地,同时可以即时提升产能,以及一个对成本敏感的价格。这意味着新的基于云的数据中心业务模型需要一个我们称之为“弹性”的大批量生产。在5G时代,5G前传类似于数据中心模式,5G后传类似于电信模式。5G光学器件的长期趋势是,它将是高速增长市场的一部分,这个市场对带宽有不同的要求,即包括对不同高速收发器的需求。由于5G和数据中心市场上快速的技术创新和产品迭代,量产制造商需要比过去有更高的灵活性。这对光子器件供应商提出了新的挑战。

图2 新的基于云的数据中心的模型与传统的以电信为中心的模型比较
MRSI-HVM解决方案
MRSI的MRSI- HVM凭借高水平的灵活芯片贴片工艺和长期的机器稳定性,以行业领先的速度实现了<±3微米粘片后的精度(见图3)。该机器旨在为光电子行业提供最新灵活的量产制造解决方案。为了达到<±3微米 @ 3σ的贴片后的精度,芯片贴片机本身应具有<±1.5×m @ 3σ的取放精度。该机器的设计配置了双贴片头和双共晶台,“在飞行中”实现吸头工具的同步切换,可以在同一台设备上实现适应于不同芯片贴片工艺的高速批量制造。此外,该解决方案还可以作为一个芯片贴片单元,支持光器件柔性制造系统中不同类型的芯片贴片工艺,以及与其他制造单元连接的连线系统,实现人工智能工厂。
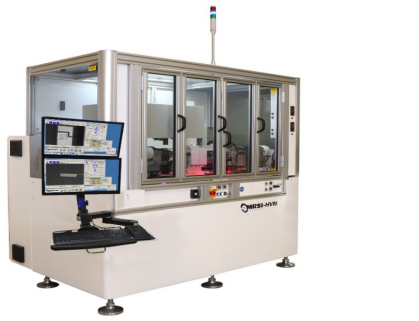
图3 MRSI-HVM 1.5微米的高速,高灵活性贴片机
MRSI-HVM的应用测试结果
MRSI-HVM是现在唯一一款可实现<±1.5 微米@3σ的灵活高速贴片机,全球已装机数十台,效果优异。它为制造5G和数据中心核心器件提供了高混合大批量的最佳制造解决方案。
MRSI用工业标准玻璃芯片验证了MRSI- HVM机的精度。左边头和右边头分别进行了100个玻璃芯片的取放精度试验,以验证两个头的机器精度。图4显示了MRSI-HVM左(M1)和右(M2)头玻璃芯片的取放精度的分布结果,两个头都满足<±1微米 @ 3σ的精度。对于右侧有加热头的配置,MRSI-HVM平台也可以获得相同级别的测试结果。
在客户的生产线上,MRSI的解决方案以行业领先的速度实现了<±3微米贴片后的精度。下面的图5显示了一个典型的芯片到载体AuSn共晶工艺的500个生产数据。结果表明,MRSI-HVM贴片后能够达到较高的精度X<±3微米@3σ,Y<±3×m微米@3σ,角度< 0.5°@3σ。贴片后的精度数据结果展示了小于±3微米的贴片后的精度。环氧蘸胶工艺的玻璃芯片取放精度是一样的,固化后的偏移量取决于每个客户的工艺设计。如果采用原位紫外光固化环氧胶的工艺,固化后的精度也可小于3微米。
MRSI-HVM机器UPH最高可达1800 (随应用不同而有差异), 机器一直在生产中7天24小时在现场运行。
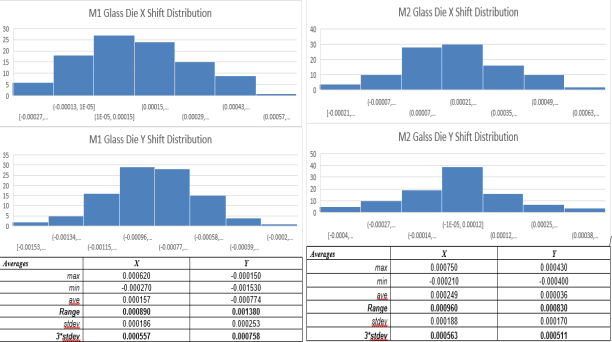
图4 玻璃芯片在机器左(M1)和右(M2)头的取放位置精度分布结果 (尺寸单位:mm)




图5 MRSI-HVM的500个CoC量产数据测量结果 (尺寸单位:mm)
小结
综上所述,在5G和数据中心应用需求的驱动下,高性能光通信器件制造商面临着重大挑战。大批量、高混合生产制造需要封装设备能够同时满足高精度、高产出、高灵活性和高稳定性。我们的现场应用结果显示,MRSI创新的自动化解决方案和MRSI-HVM系列机器可以回应这些挑战。我们的系统可满足光器件“弹性”量产的制造要求,在生产环境实现了贴片后<±3微米的目标。
参考文献:
1. Cisco Annual Internet Report, 2018-2023
2. Lightcounting Market Research Report, May 2020
3. Limin Zhou, et. al “High-power Laser Diodes: Die-bonder innovations target HPLD manufacturing challenges”, Laser Focus World, Feb 18th, 2020
4. Yi Qian, “Manufacturing Photonics: Challenges for photonics manufacturing in the new data center ear”, Laser Focus World, Aug 1st, 2018
注: 原文《The most accurate high-volume and flexible die bonding solution for model photonics manufacturing》发表于 Laser Focus World, July 2020.
MRSI Systems
Mycronic集团旗下的MRSI Systems是全自动、高速、高精度、灵活多功能的贴片系统的领先制造商。我们为激光器、探测器、调制器、AOC、WDM/EML TO-Can、光收发器、LiDAR、VR/AR、传感器和光学成像等产品的研发、小到中等批量生产, 直至大批量生产提供“一站式”解决方案。 凭借30多年的行业经验和我们遍布全球的本地技术支持团队,我们为所有级别的封装提供最有效的系统和组装解决方案,其中包括晶片芯片(CoW)、基板芯片(CoC)、PCB和管盒封装。有关详细信息,请访问MRSI Systems官网。
Mycronic
Mycronic是一家从事生产设备开发、制造和销售的瑞典高科技公司,满足电子行业高精度和灵活性的要求。Mycronic总部位于斯德哥尔摩北部的Taby,该集团在中国、法国、德国、日本、新加坡、韩国、荷兰、英国和美国均设有分公司。Mycronic (MYCR)在纳斯达克斯德哥尔摩上市。

图片新闻
最新活动更多
-
4月30日立即报名>> 2026光学行业应用创新发展蓝皮书火热招编中!
-
即日-4.30立即下载>>> 【限时下载】《2025激光行业应用创新发展蓝皮书》
-
即日-5.31立即申报>>> 维科杯·OFweek 2026光学行业年度评选
-
5月31日立即申报>>> 维科杯•OFweek 2026激光行业年度评选
-
7月15-16日报名参会>>> OFweek 2026中国激光产业高质量发展峰会
-
精彩回顾立即查看>> 2026上海慕尼黑光博会维科网·VIP企业展台巡展直播
推荐专题







 分享
分享















发表评论
登录
手机
验证码
手机/邮箱/用户名
密码
立即登录即可访问所有OFweek服务
还不是会员?免费注册
忘记密码其他方式
请输入评论内容...
请输入评论/评论长度6~500个字
暂无评论
暂无评论