0.1纳米时代!巨头发力下一代晶体管CFET

?尽管摩尔定律的增速已显著放缓,但工艺节点依然稳步向前,现已演进至2nm甚至1nm以下。而在最新的逻辑节点中,传统器件架构已不具优势,而互补场效应晶体管(CFET)则被看做“成大事者”,成为埃米时代(1埃米等于0.1纳米)的主流架构。那么CFET究竟有着怎样的魅力?
01
为什么需要CFET?
CFET,作为一种创新的CMOS工艺,以其晶体管垂直堆叠的独特方式,突破了传统平面工艺、FinFET(鳍式场效应晶体管)以及GAAFET( 环绕式栅极技术晶体管)的平面局限。
至于为何CFET架构备受瞩目?让我们一窥FinFET与GAAFET在当前技术挑战下所遭遇的瓶颈,便不难理解CFET为何值得深入研究。
先看FinFET。
FinFET是一种新的互补式金属氧化物半导体晶体管,该项技术的发明人是加州大学伯克利分校的胡正明教授。
2011年,英特尔率先将FinFET技术商业化,并应用于22nm制程,显著提升性能与降低功耗。随后,台积电、三星等厂商跟进,FinFET技术大放异彩。之后为了提高晶体管性能并进一步减小面积,FinFET体系架构也进行了持续的改进。自16/14nm起,FinFET成为主流选择,推动半导体工艺发展至3nm节点。然而,实际上自进入5nm后,FinFET就开始面临鳍片稳定性、栅极宽度限制及静电问题等挑战。修修补补的FinFET终将力不从心,新的架构因此呼之欲出。
下面接棒的选手便是GAAFET。GAAFET即环绕栅极场效应晶体管,其架构本质就是把FinFET的Fin旋转90°,然后把多个Fin横向叠起来,这些Fin都穿过gate。
GAAFET有两种结构,一种是使用纳米线(Nanowire)作为电子晶体管鳍片的GAAFET;另一种则是以纳米片(Nanosheet)形式出现的具有较厚鳍片的多桥通道场效应管MBCFET。
据悉,三星在3nm制程节点就已经导入GAAFET架构,而台积电将在2nm制程节点首度应用GAAFET晶体管,英特尔此前表示将在Intel 20A工艺上,引入采用GAA设计的RibbonFET晶体管架构。

随着GAAFET晶体管的gate(门)与channel(沟道)的接触面积变大,而且对于FinFET而言,Fin的宽度是个定值;但对GAAFET而言,sheet(薄片)本身的宽度与有效沟道宽度是灵活可变的。更宽的sheet自然能够达成更高的驱动电流和性能,更窄的sheet则占用更小的面积自然可以提供比FinFET 更好的静电特性,满足某些栅极宽度的需求。
在同等尺寸结构下,GAAFET 的沟道控制能力得到强化,尺寸进一步微缩更有可能性,且新的结构所需的生产工艺应该与鳍式晶体管相似,可以继续使用现有的设备以及技术成果。
不过,GAAFET虽然已经实现了在3nm甚至2nm工艺中的应用,但进一步缩小到1nm以下将面临巨大的工艺挑战。
这时,业界的科技巨头们又开始纷纷调整策略,将他们的目光和精力聚焦在了CFET这一新兴技术上。
02
CFET大展身手
CFET将不同导电沟道类型(N-FET和P-FET)的GAA器件在垂直方向进行高密度三维单片集成。
相较于现有主流FinFET与GAAFET晶体管集成电路工艺,CFET突破了传统N/P-FET共平面布局间距的尺寸限制,可将集成电路中逻辑标准单元尺度微缩到4-T(Track)高度,同时将减少SRAM单元面积40%以上。在追求极致性能与密度的未来科技领域,CFET无疑将成为基础晶体管器件创新架构的有力候选者。
在2023的IEEE国际电子器件会议上,台积电发布了一篇标题《面向未来逻辑技术扩展的 48 纳米栅极间距的互补场效应晶体管 (CFET) 》的论文,其器件的与众不同之处在于采用了一种新方法,在顶部和底部器件之间形成一个介电层,以保持它们之间的隔离。纳米片一般由硅层和硅锗层交替形成。在工艺的适当步骤中,硅锗特定蚀刻方法会去除这些材料,从而释放出硅纳米线。台积电使用硅锗层将两个器件隔离开来,因为知道硅锗层的蚀刻速度比其他硅锗层快,所以使用了锗含量特别高的硅锗层。这样,隔离层就可以在释放硅纳米线之前分几步制作完成。
近日,台积电资深副总经理暨副共同首席运营官张晓强在2024技术论坛上宣布,台积电已成功集成不同晶体管架构,在实验室做出CFET。张晓强指出,CFET预计将被导入下一代的先进逻辑工艺。CFET是2nm工艺采用的纳米片场效应晶体管架构后,下一个全新的晶体管架构。
不仅是台积电,还包括三星、英特尔在内的芯片三巨头,都对CFET的开发给予高度重视。
英特尔是三家中最早演示CFET的,早在 2020 年就在 IEDM 上推出了早期版本,随后在2023的IEEE国际电子器件会议上,围绕 CFET 制造的最简单电路(inverter)做了多项改进。英特尔组件研究小组首席工程师Marko Radosavljevic表示:“inverter是在单个鳍片上完成的。在最大缩放比例下,它将是普通CMOS逆变器尺寸的50%。”此外,英特尔还通过将每个器件的纳米片数量从2个增加到3个,将两个器件之间的间距从50 nm减小到30 nm。
三星对CFET的开发也很积极。在去年的IEEE会议上,三星演示了48nm和45nm接触式多晶硅间距 (CPP) 的结果。不过这些结果是针对单个器件,而不是完整的逆变器。虽然三星的两个原型 CFET 中较小的一款性能有所下降,但幅度不大,该公司的研究人员相信制造工艺优化将解决这一问题。
三星成功的关键在于能够对堆叠 pFET 和 nFET 器件的源极和漏极进行电气隔离。如果没有足够的隔离,这种被三星称为三维堆叠场效应晶体管(3DSFET)的器件就会泄漏电流。实现这种隔离的关键步骤是将涉及湿化学品的蚀刻步骤换成一种新型的干式蚀刻。这使得良好器件的产量提高了 80%。
与英特尔一样,三星也从硅片下方接触器件底部,以节省空间。不过,这家韩国芯片制造商与美国公司不同的是,在每个配对器件中只使用了1片纳米片,而不是英特尔的3片。据其研究人员称,增加纳米片的数量将提高 CFET 的性能。
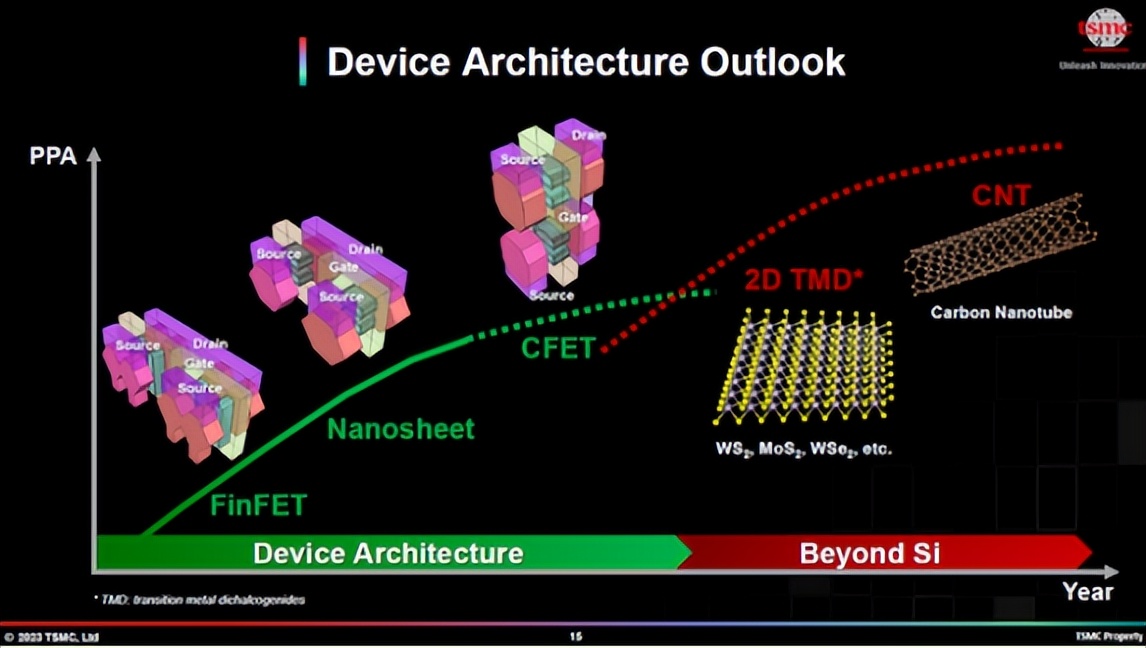
当然,除芯片三巨头之外,其他国家和地区的企业和研究机构也在积极参与CFET的开发与研制。
早在2000年前后北京大学就已经提出了三维堆叠互补晶体管的概念,并在2004年研发完成堆叠互补晶体管的雏形,发表了论文《A stacked CMOS technology on SOI substrate》同时还以第一专利权人在国内申请了专利《一种位于SOI衬底上的CMOS电路结构及其制作方法》。只是这一概念在当时太过超前,未引起太多关注。
近几年来,该论文及其后续工作已被国际发明专利引用数百次且受到产业巨头的推崇,IEDM 2021大会中英特尔的有关晶体管堆叠技术的邀请报告《Opportunities in 3-D stacked CMOS transistors》中就引用了上述论文,且是引用文献中时间最早的一篇;台积电在VLSI 2021的报告《CMOS Device Technology for the Next Decade》中指出,北京大学的3D Stacked CMOS晶体管是业界第一个堆叠互补晶体管,比台积电和英特尔要早15年。
在IEDM 2021上,北京大学集成电路学院发表题为《Demonstration of Vertically-Stacked CVD Monolayer Channels:MoS2 Nanosheets GAA-FET with Ion>700μA/μm and MoS2/WSe2 CFET”》的论文,展示了基于单层二硫化钼的堆叠围栅纳米片器件,实现了开态电流超过400μA/μm(@Vd=1V)或700μA/μm(@Vd=2V),该结果远超同类器件的文献报道水平;并通过上百个器件的统计分析,显示了该器件由三维集成和尺寸缩小带来的性能提升;同时,首次报道了亚1纳米沟道厚度的二硫化钼/二硒化钨CFET器件,实现了反相器逻辑功能。
2022年12月Nature Electronics发表了复旦大学微电子学院题为“Heterogeneous Complementary Field-effect Transistors Based on Silicon and Molybdenum Disulfide”的论文,团队将新型二维原子晶体引入传统的硅基芯片制造流程,实现了晶圆级异质CFET技术。相比于硅材料,二维原子晶体的原子层精度使其在小尺寸器件中具有优越的短沟道控制能力。利用硅基集成电路的标准后端工艺,将新型二维材料MoS2三维堆叠在传统的硅基芯片上,利用两者高度匹配的物理特性,形成p型硅-n型MoS2的异质CFET结构。在相同的工艺节点下将集成电路的集成密度翻倍,并获得了优越的器件性能。
03
1nm何时到来?
Tom's Hardware 报道,英特尔在 IFS Direct Connect 大会上的一次闭门活动上确认,按目前计划,14A 节点的“有意义”规模量产将落在 2026 年;而暂未正式公布的下一个制程节点 10A 预期于 2027 年底投产。
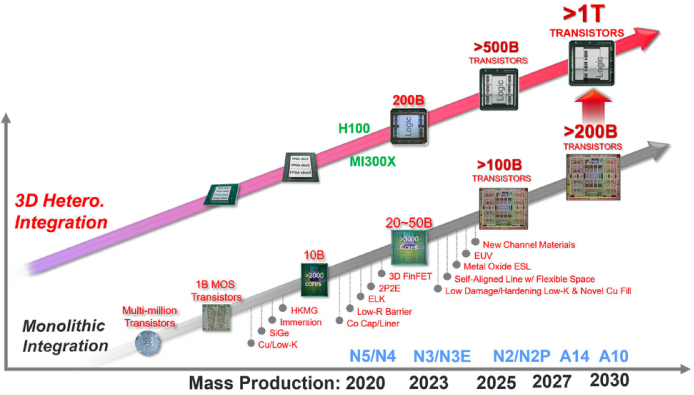
台积电日前在2023年IEEE国际电子元件会议(IEDM)上,发布进军至1nm制程的产品规划蓝图。根据规划,台积电将并行推动3D封装和单芯片封装的技术路径的发展。预计在2025年,台积电将完成N2和N2P节点,使得采用3D封装的芯片晶体管数量超过5000亿个,而采用传统封装技术的芯片晶体管数量超过1000亿个。
然后,台积电计划在2027年达到A14节点,并在2030年达到A10节点,即1nm制程芯片。届时,采用台积电3D封装技术的芯片晶体管数量将超过1万亿个,而采用传统封装技术的芯片晶体管数量将超过2000亿个。
IBM一直是半导体技术革新的领跑者。2021年,IBM宣布推出全球首款2nm芯片。与此同时,IBM也早早开始对1nm技术进行研究。在2022年末的 IEDM 会议上,IBM展示了其为通向1nm及以上准备的技术:互连3.0和VTFET。
2022年,日本芯片制造商Rapidus、东京大学将与法国半导体研究机构Leti合作,共同致力于开发1nm制程半导体。这种跨国合作模式为技术创新提供了新的视角和资源,有望加速1nm技术的研发进程。
2023年5月,Imec公布了其1nm以下晶体管的路线图,展示了未来几年内实现1nm制程的可能路径和技术难点。Imec正致力于开发远超现有技术极限的产品。随后在6月,IMEC还与 ASML达成协议,双方将在开发最先进高数值孔径(High-NA)极紫外(EUV)光刻试验线的下一阶段加强合作,为使用半导体技术的行业提供原型设计平台和未开发的未来机遇。
IMEC CMOS总监Naoto Horiguchi在国际电子器件会议演讲时表示:“仅使用GAA来缩放CMOS器件是非常困难的。借助 CFET,我们可以继续器件扩展,然后可以将其与Chiplet和先进封装等其他技术相结合,以提高芯片性能。CFET正在为器件的持续扩展开辟一条道路。”IMEC 预计,CFET架构将在2032年左右超越1nm节点。
然而,值得注意的是,CFET面临的问题还有很多,特别是未来量产过程中,CFET的制造将更加困难。一方面CFET架构比GAA架构的3D结构更高,结构纵横比的增加将带来更大的制造挑战;另一方面,CFET需要非常高的掺杂剂激活,需要非常低的接触电阻率,需要为CFET提供特殊的高k/金属栅极,而且这些都必须在非常高的堆叠结构中完成。
台积电表示,CFET架构的重大挑战可能会导致工艺复杂性和成本增加。“为了克服这些挑战,必须仔细选择集成方案,以降低工艺复杂性,并最大限度地减少对新材料和工艺能力的要求。”台积电器件架构开拓总监Szuya Liao表示,“参与早期 EDA/流程工具开发,为重大设计变更做好准备也很重要。”
原文标题 : 0.1纳米时代!巨头发力下一代晶体管CFET

图片新闻
最新活动更多
-
7月30-31日报名参会>>> 全数会2025中国激光产业高质量发展峰会
-
7.30-8.1马上报名>>> 【展会】全数会 2025先进激光及工业光电展
-
免费参会立即报名>> 7月30日- 8月1日 2025全数会工业芯片与传感仪表展
-
精彩回顾立即查看>> 维度光电·引领光束质量分析应用全新浪潮【免费下载白皮书】
-
精彩回顾立即查看>> 2024(第五届)全球数字经济产业大会暨展览会
-
精彩回顾立即查看>> 【线下会议】全数会2024电子元器件展览会
推荐专题







 分享
分享















发表评论
请输入评论内容...
请输入评论/评论长度6~500个字
暂无评论
暂无评论